
扫码添加微信,获取更多半导体相关资料
本文提出了一种利用原子力显微镜(AFM)测量硅蚀刻速率的简单方法,应用硅表面的天然氧化物层作为掩膜,通过无损摩擦化学去除去除部分天然氧化物,暴露地下新鲜硅。因此,可以实现在氢氧化钾溶液中对硅的选择性蚀刻,通过原子精密的AFM可以检测到硅的蚀刻深度,从而获得了氢氧化钾溶液中精确的硅的蚀刻速率。
首先,在乙醇中通过超声波清洗硅基底,使用原子力显微镜,在潮湿空气(相对湿度≃50%)划伤二氧化硅尖端后,通过摩擦化学去除清洁硅基板表面3×3μm2方形区域内的天然氧化物,如图所示1,磨损面积的深度为∼2nm,超过了天然氧化硅的厚度,因此,四方形区域的新鲜地下硅原子被暴露出来,利用真空中的氮化硅尖端进行AFM表面形貌扫描,确定了硅基底表面的方形区域的表面形貌和方形区域的深度d0。
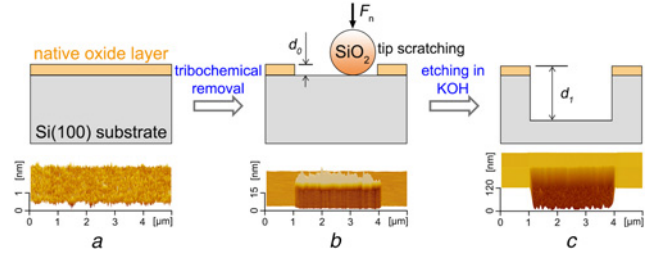
图1
第二,经过初始表面形貌扫描后,将处理后的硅衬底在室温下用一定pH的制备的氢氧化钾溶液中浸泡一定时间,硅(Si-100)的蚀刻率是氧化硅的185倍,而低浓度氢氧化钾溶液中氧化硅的蚀刻率极低。因此,在短时间内,氢氧化钾溶液几乎无法蚀刻天然氧化硅,但暴露的新鲜地下硅可以明显地蚀刻,经过一段时间后,取出硅衬底,然后用超纯水冲洗,然后,通过AFM扫描蚀刻后的硅衬底表面,得到四方形面积的深度d1。
最后,在氢氧化钾溶液中蚀刻后,可以估计硅面积的蚀刻深度,蚀刻深度Δd为d0与d1之间的差值(Δd=d1−d0),在硅衬底的蚀刻后,立即记录了蚀刻时间t,因此,得到了硅的蚀刻速率Re,即Re=Δd/t,为了获得更精确的蚀刻速率,对每个氢氧化钾溶液重复上述测量过程至少三次,并将所有蚀刻速率值平均得到硅的最终蚀刻速率。
用不同的pHs对氢氧化钾溶液中硅的蚀刻:为了验证该方法的可行性和有效性,应测量氢氧化钾溶液中硅的蚀刻速率,利用该方法在室温下,在五种pH值不同的氢氧化钾溶液中蚀刻硅,pH值表明,氢氧化钾溶液浓度相对较低(5×10−4mol/L-0.1mol/L),pH值与氢氧化钾调整泥浆一致,确保硅化学机械抛光(CMP)。因此,在这些氢氧化钾溶液中,硅的蚀刻特性不仅证实了所提出的新方法,而且可能对研究硅CMP的蚀刻行为具有重要意义,通过去除硅衬底表面的方形区域中的天然氧化物,并在氢氧化钾溶液中对暴露的新鲜硅进行了蚀刻。
简短的测量示意图如图所示2,上行的AFM图像显示磨损、未蚀刻区域的一侧,下行的AFM图像显示不同蚀刻时间t下在不同氢氧化钾溶液中蚀刻磨损区域的相应一侧,蚀刻面积的粗糙度会随着氢氧化钾溶液的pH值的增加而增加,由于空气中溶解的二氧化碳,氢氧化钾溶液的pH值可能随着蚀刻时间的增加而有一定程度的降低。由于pH值在整个蚀刻过程中的变化不超过0.3,因此可能对硅的蚀刻没有显著影响。为了产生AFM能准确检测到的适当的蚀刻深度,该蚀刻时间应适用于每个氢氧化钾溶液中的硅的蚀刻。
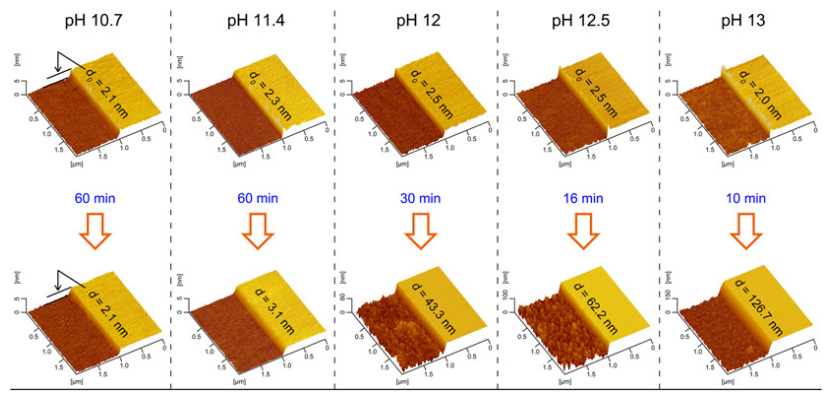
图2
除了摩擦化学去除外,没有进行任何方法在硅表面制备掩模膜的其他方法,它只用于去除部分天然氧化物以暴露新鲜的底层硅,氧化硅的蚀刻速度是氢氧化钾对硅的185倍,在低碱pH值的氢氧化钾溶液中蚀刻速率较低。因此,利用天然氧化物作为掩膜,可以实现硅衬底上硅的选择性蚀刻。
在之前的原子力显微镜研究中,硅在原子力显微镜上对二氧化硅微球进行了微/纳米耳测试,以检测硅的磨损行为,当在潮湿的空气和水中进行磨损试验时,摩擦化学反应导致了硅表面的物质去除,透射电子显微镜对硅表面磨损区域的观察表明,磨损区域下的硅原子和晶格保持了其完整性。因此,硅的结构没有受到破坏。在上述研究的基础上,可以在不破坏硅衬底表面的天然氧化物而去除硅衬底表面的天然氧化物,从而确保硅衬底表面的光滑蚀刻。
在其他氢氧化钾溶液(pH分别为10.7、12和12.5)中进行相同的测量过程,由于实验误差,每个测量结果之间的差异可能会出现在重复测量过程中,pH为11.4的氢氧化钾中硅的刻蚀深度较浅,蚀刻时间长,三个测量步骤的蚀刻深度Δd分别为0.4、0.4和0.3nm,每次蚀刻时间为30min,因此,平均蚀刻速率约为0.012nm/min,尽管蚀刻速率较低,但AFM可以精确地检测到蚀刻深度,并得到了蚀刻速率。
在之前的研究中,我们测量了氢氧化钾溶液中的静态蚀刻速率作为pH(11-13)的函数,以研究硅的蚀刻机理,通过该方法测定的硅的蚀刻速率的变化几乎与之前的静态蚀刻速率的变化相一致,从而证实了该方法的有效性。
综上所述,在硅表面自然形成的天然氧化物作为掩膜,通过摩擦化学去除硅衬底表面的部分天然氧化物会产生硅的选择性蚀刻,利用原子力显微镜,氢氧化钾溶液中硅的蚀刻率。这些特征表明,所提出的测量硅蚀刻速率的方法具有合理的创新性。
最后通过提出简单、低成本的氢氧化钾溶液中硅蚀刻速率的测定方法,硅衬底表面上的天然氧化物作为掩膜,以实现硅的选择性蚀刻。在该方法中,通过对原子力显微镜上的二氧化硅微球的摩擦化学反应,部分去除硅衬底上的天然氧化物,去除过程不会破坏地下硅的结构。因此,新鲜的地下硅可以平滑地暴露和蚀刻,通过对AFM的原子精度测量,可以检测到硅的超浅蚀刻深度,这可以在低碱pH(或超低浓度)的氢氧化钾溶液中获得蚀刻速率,该方法可以提供一种新的、简单的测量某些材料蚀刻速率的概念,并确保材料蚀刻工艺设计所需的蚀刻速率的高精度测量。