
扫码添加微信,获取更多半导体相关资料
摘要
本文介绍了用兆频超声波能量从有机溶剂中的硅片上去除颗粒的实验。纳米粒子首先通过可控污染工艺沉积在硅晶片上。对于新沉积和老化的颗粒,研究了作为兆频超声波功率的函数的颗粒去除效率。通过改变处理条件和漂洗时间化学成分,对几种清洗配方进行评估。当使用低兆声波功率时,发现粒子在分离后聚集并重新沉积在晶片表面上。这种现象可以用特定溶剂中颗粒和硅表面的带电现象来解释。添加表面活性剂以防止聚集和再沉积,从而显著提高颗粒去除效率。
介绍
有机溶剂越来越多地被研究作为传统水基化学的潜在替代品。由megasounds辅助的湿法清洗在去除纳米颗粒方面表现出高性能,而没有显著的基底损失。最近,有机溶剂和megasounds的组合使用在去除蚀刻后的PR,包括等离子体改性的外壳方面显示出有希望的能力。此外,中等极性的溶剂显示出诱导表面带电,并在类似带电表面的情况下刺激形成颗粒沉积的静电屏障。在将兆频超声波能量的高清洁性能与合适的有机溶剂的优点相结合的想法的引导下,我们在这项工作中评估了使用兆频超声波在有机溶剂中实现的从硅衬底去除颗粒的效率。研究了两种粒子:作为一般清洁应用的模型粒子的氧化硅,和在化学成分方面可能类似于蚀刻后PR外壳的交联聚甲基丙烯酸甲酯(PMMA)粒子。选择n-甲基吡咯烷酮(NMP)作为溶剂,因为它通常用于PR剥离工艺。测量水、异丙醇和NMP中的粒子电势,以估计粒子和基底之间的静电相互作用。颗粒去除效率和防止颗粒再沉积被评估为颗粒类型、施加的声功率和清洁配方的函数。对在水中获得的颗粒去除进行了交叉比较。
材料和方法
二氧化硅和聚甲基丙烯酸甲酯球形颗粒用于这项工作,直径分别为78纳米和300纳米。后者是自制合成的,显示出约5%的交联。这两种颗粒均可作为含水浆料(30重量%)获得。在被颗粒污染之前,覆盖200毫米p型硅晶片接受了IMEC清洗,并进行批量马兰戈尼干燥,最后是漫长的O3步骤。
在清洁之前和之后,使用激光散射晶圆图(KLA-坦科的Surfscan SP1 DLS工具)进行粒子检查。使用雾度法(7)或更精确的光点缺陷(LPD)检查来量化晶片上的粒子浓度。后者可以检测沉积粒子的确切数量及其尺寸分布,从而能够区分单个粒子和簇、感兴趣的特定粒子和交叉污染物。使用乳胶球当量直径报告颗粒尺寸。使用Klarity软件(KLA-腾科)进行图对图分析,以确定清洁前后去除的、添加的和常见的颗粒数量。
结果
图2(a)和图2(b)分别收集了在不同兆频超声波功率下使用配方1 (NMP)获得的聚甲基丙烯酸甲酯和二氧化硅颗粒的性能。
图3显示了在NMP使用30 W的功率去除聚甲基丙烯酸甲酯颗粒的情况下雾度的径向分布。在晶片的中心,清洁过程后雾度降低,表明颗粒被有效去除。然而,在大于20毫米的径向距离处,该图显示了交叉,这提供了清洁后雾度增加的证据。这种现象可归因于不均匀的清洁和分离颗粒的优先再沉积。
图4总结了二氧化硅和聚甲基丙烯酸甲酯颗粒在最高功率(75 W)下用NMP或水处理的颗粒去除效率。在所有情况下,二氧化硅颗粒比聚甲基丙烯酸甲酯更容易去除。这一事实可归因于聚甲基丙烯酸甲酯的再沉积,但也归因于聚甲基丙烯酸甲酯相对于二氧化硅的更高变形,这导致与晶片表面的更大接触面积和颗粒老化后更强的范德华引力。
如图7所示,二氧化硅颗粒在所有介质中都带负电荷,在水<异丙醇< NMP的顺序中,绝对电荷增加;PMMA颗粒在所有溶剂中都带正电荷。然而,NMP的正电荷数量很少。因此,聚甲基丙烯酸甲酯颗粒在NMP聚集形成大的团簇,因为它们之间的范德华引力克服了低静电排斥。在所有其他情况下,粒子表面电荷非常高,因此它会引起类似粒子之间的强烈的静电排斥力,从而阻止凝固。由于表面电荷相反,PMMA粒子有望在所有三种溶剂中重新沉积在二氧化硅表面。此外,团簇和表面之间的引力远高于离散粒子。因此,团簇一旦形成,就会沉积在表面上。
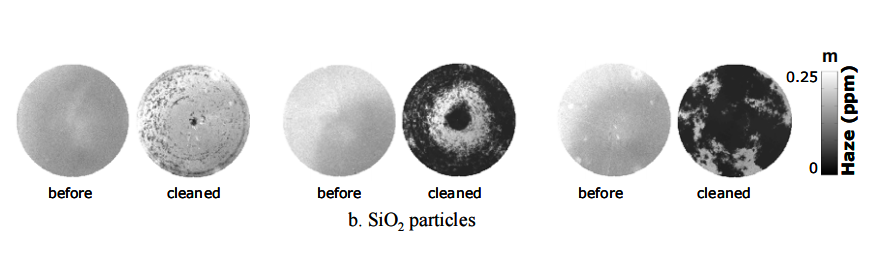
图2 Wafer图显示了在NMP中清洗a)PMMA和b)二氧化硅颗粒前后晶片的雾霾。颗粒老化时间:12h
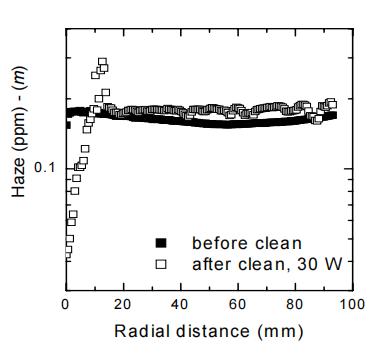
图3 在NMP中使用30W的超气功率清洗PMMA颗粒前后雾霾值的径向分布
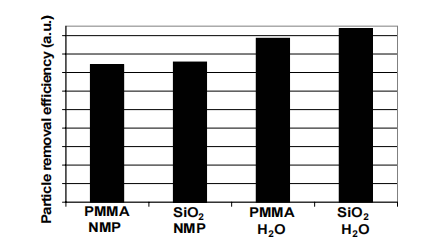
图4 二氧化硅和PMMA颗粒的平均PRE,在NMP或水中,分别使用配方1和6,在75W。来自雾霾的PRE值。边缘排除:2cm
理论
在这项工作中,在水中和NMP使用兆频超声波能量测试了从硅晶片中去除二氧化硅和聚甲基丙烯酸甲酯颗粒。在水中,两种类型的颗粒都被均匀地去除,并且去除效率随着施加的兆频超声波功率而增加。然而,在NMP和低功率下,发现聚甲基丙烯酸甲酯颗粒形成大簇,在分离后重新沉积在晶片表面。Zeta电位测量显示,在NMP和异丙醇中,聚甲基丙烯酸甲酯和二氧化硅表面带相反电荷,这可以解释冲洗过程中聚甲基丙烯酸甲酯的再沉积。此外,NMP聚甲基丙烯酸甲酯的低ζ电势由于主要的分散相互作用而导致颗粒聚集。在NMP引入非离子表面活性剂显示出改善的颗粒去除和防止聚集,这是由于形成了凝固的空间屏障。
文章全部详情,请加华林科纳V了解:壹叁叁伍捌零陆肆叁叁叁