
扫码添加微信,获取更多半导体相关资料
摘要
集成器件制造的精细图案化工艺要求具有湿式化学加工中的表面清洁度、表面平滑度、完全均匀性和完全蚀刻线性等优点。在我们的工作中,基于对BHF和SO的化学反应机理的基础研究,确定了缓冲氟化氢(BHF:NH4F+HF+H2O)的改进化学组成。描述了基于化学反应机理和液体化学品性质研究的先进湿式化学加工,结合SiO2 BHF的图案化工艺。硅技术的湿化学工艺原理基于以下四个要素:主要反应的测定(蚀刻种类、BHF蚀刻产物的溶解度对蚀刻均匀性和线性、无固相分离的化学成分的稳定性,以及通过添加表面活性剂提高晶圆表面液体化学品的润湿性。
介绍
化学反应是渐进式ULSI加工的必要要求。特别是,由于器件集成的改进通常需要高纵横比接触和通过孔的精细图案,表面化学技术必须实现晶圆表面的完美光滑。酸性氟化铵溶液,被称为缓冲氟化氢(BHF),是一种重要的化合物,因为它对硅化合物的反应性。它被广泛用作表面处理剂,如刻蚀,图案和清洁硅片表面。为了提高湿法蚀刻技术,必须提高BHF的化学活性和功能性能。本研究基于NH4FHFH20体系解离的光谱研究,从理论上考虑了BHF的化学成分。
硅技术中湿式化学加工的基本原理
优势反应(蚀刻)
从图中可以看出。Si02的蚀刻速率随着高频浓度的增加而增加,但它几乎与等效摩尔比线以上的NH4F浓度无关。另一方面,已经发现,Si02薄膜不是用NH4F溶液蚀刻,这是一种强电解质,即溶液中存在大量的f离子。这两个结果似乎表明,SiOz的优势蚀刻物种是HF;,而不是F-离子。NH4F溶液的电导率如图所示。 我们用铂制成的平行电极测量了电导率。单元格常数为1.025,并在3000Hz下进行。随着NH4F浓度的增加,电导率增加,在浓度为7aol/l时达到最大值,然后降低。在-300I-8 200 >Ecv2中,离子的有效离子浓度比值随着NH、F的增加而减小。
蚀刻溶液中反应(蚀刻)产品的溶解性
六氟硅酸铵((NH、)、SiF)是由SiO和BHF反应产生的。通过过滤和收集未溶解部分,我们测量了(NH4)2SiF)在几种BHF成分中的溶解度,并将其作为NH4F浓度的函数绘制在图中9。从上述结果可以看出,蚀刻线性随着BHF的提高而增强。这是由于反应产物的溶解度增加所致。在显微镜下,通过蚀刻表面的干涉颜色可以很容易地观察到不均匀的蚀刻。因此,反应产物((NH、)、SiF6)的局部饱和会导致蚀刻速率的抑制。改进的BHF和先进的BHF没有显示出这种饱和效应,因为(NH4)(SiF6)在这些溶液中具有较高的溶解度。因此,可以得出结论,蚀刻溶液的组成必须被设计为最大限度地提高蚀刻反应产物的溶解度。
化学成分的稳定性
传统的BHF在运输和储存过程中,尤其是NH、HF的固相分离,特别是在冬季。在高频浓度为6-8%的常规BHF中,固相分离发生在9-17“c的倾斜温度处。测量了固相分离温度与NH4F浓度之间的关系,如图所示。 11.冻结凹陷曲线和溶解度曲线两种关系有一个交点。这代表了最小的固相分离温度。
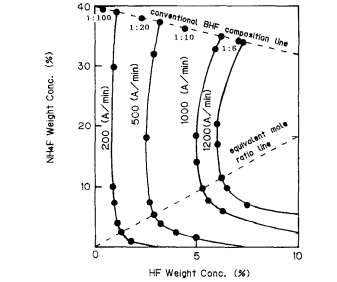
图1 NH4F-HF-H2O体系中成分与热氧化物蚀刻速率的关系

图4 NH4F-HF-H2O体系的红外吸收光谱
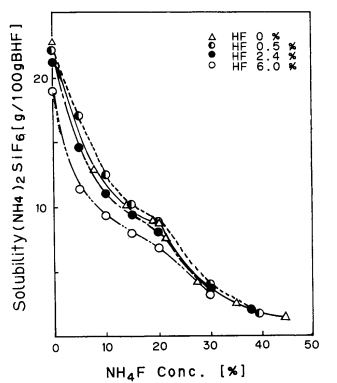
图9 六氟硅酸铵NH4)、SiF在NH4F-HF-H2)溶液中与25°C下NH4F浓度的溶解度
总结
基于液体化学物质的电离机制和表面化学反应,从理论的角度研究了BHF的化学成分的改进。对BHF的解离机理进行了理论和实验研究,结论是HF2是Si02蚀刻过程中主要的活性离子种类。测定了氧化硅薄膜的蚀刻速率与H+离子浓度的关系。NH4F-HF-H2O体系中SiO、薄膜的刻蚀刻速率随HF;离子浓度呈线性增加,而随着H+离子浓度的降低呈对数下降,即使HF;离子浓度保持不变。我们的结论是蚀刻溶液的液体化学成分必须选择具有最合适的高频浓度和离子种类。
液体化学物质的组成和性质应考虑以下特性:蚀刻产物在蚀刻溶液中的充分溶解度、固相的充分分离温度和优异的润湿性。1)具有NH4F浓度过量的BHF的普通成分会导致一些严重的问题,过量的NH4F不会导致与氧化硅的离子反应,由于BHF中缺乏蚀刻产物的溶解性,严重降低了蚀刻的均匀性和线性。2)我们发现,SiO蚀刻产物的溶解度在BHF中随着NH4F浓度的降低而增加。3)另一个实际障碍是NH4HF2低温环境下晶体的固相分离。这种固相分离产生粒子,并导致液体化学成分的成分变化。考虑到液体化学品的运输和储存,特别是在冬季,固相分离温度必须尽可能低。改进的BHF组成,NH4F浓度约为15%,被限制以解决这些问题,并以完全线性和均匀性进行蚀刻。4)通过适当添加表面活性剂,液体化学物质在晶片表面表现出良好的润湿性,并允许进行高质量的湿式化学加工。在SiO后,晶片表面完全平滑,通过引入NH4F浓度为15%的先进表面活性BHF和选定的碳氢化合物表面活性剂,如脂肪族胺和脂肪族醇来实现蚀刻。
文章全部详情,请加华林科纳V了解:壹叁叁伍捌零陆肆叁叁叁